Ce este Ball Grid Array (BGA)?Beneficii, tipuri, proces de asamblare
2025-08-25
11697
Catalog

Figura 1. Mare de grilă cu bilă (BGA)
Ce este un tablou de grilă cu bilă (BGA)?
Un tablou BGA sau Ball Grid este un tip de ambalaje de cip utilizate pentru conectarea circuitelor integrate (ICS) direct pe o placă de circuit imprimat (PCB).În loc de ace, BGA are multe bile minuscule de lipit aranjate într -o grilă de pe partea inferioară.Când sunt încălzite, aceste bile de lipit se topesc și atașează cipul pe placă, creând atât legătura fizică, cât și conexiunile electrice.Deoarece întreaga suprafață de jos este utilizată pentru conexiuni, BGA-urile se pot potrivi cu mai multe conexiuni într-un spațiu mic în comparație cu pachetele mai vechi pe bază de pini.
BGA -urile sunt, de asemenea, mai bune la transportarea rapidă a semnalelor electrice și la răspândirea căldurii, astfel încât cipul să poată rula mai repede și să rămână mai rece.BGA-urile sunt utilizate pe scară largă pe dispozitive moderne, cum ar fi microprocesoare, carduri grafice și alte electronice de înaltă performanță, unde sunt necesare dimensiuni, viteză și fiabilitate compacte.
Cum funcționează pachetele pentru modul în care funcționează pachetele de bilă (BGA)
Ball Grid Matric (BGA) funcționează folosind bile minuscule de lipit în partea de jos a cipului pentru a -l conecta la placa de circuit imprimată (PCB).Fiecare bilă de lipit se potrivește cu un mic tampon pe tablă.Când cipul este așezat pe tablă și încălzit într -un cuptor special, bilele de lipit se topește și se lipesc de plăcuțe.După răcire, lipirea devine din nou solidă, creând căi electrice puternice și ținând cipul ferm pe loc.Un lucru inteligent despre BGA este faptul că lipitul topit ajută cipul „alinierea”.Aceasta înseamnă că cipul se poate ajusta în poziția corectă în timpul încălzirii, ceea ce reduce greșelile care se întâmplă cu cipurile mai vechi pe bază de pin.
Cu bile de lipit răspândite uniform, semnalele se deplasează mai repede, zgomotul este redus și căldura se deplasează în placă pentru a menține cipul mai răcoros.Și din moment ce articulațiile de lipit sunt ascunse sub cip, acestea nu pot fi văzute direct.Pentru a verifica dacă conexiunile sunt bune, sunt necesare instrumente speciale precum mașinile cu raze X.Dacă se întâmplă o problemă, fixarea sau înlocuirea unui cip BGA necesită echipamente speciale, ceea ce face ca reparația să fie mai grea decât tipurile de pachete mai vechi.
De ce să alegeți pachete cu bilă de grilă (BGA)

Figura 2..
Pachetele de grilă cu bilă (BGA) sunt preferate, deoarece rezolvă multe probleme găsite în proiectele de cipuri mai vechi, cum ar fi pachetele plate quad (QFPS).În QFPS, cipul se conectează la placă prin pini foarte subțiri așezați îndeaproape de -a lungul marginilor.Acești pini se pot îndoi sau rupe ușor, ceea ce face ca reparațiile să fie dure și costisitoare.Distanța îngustă crește, de asemenea, riscul de greșeli în timpul lipitului, cum ar fi pinii care se ating reciproc și determină eșecul circuitului.În plus, pinii aglomerați îngreunează proiectarea plăcii de circuite imprimate (PCB), deoarece rutarea tuturor căilor din jurul lor duce la blocare și limitează performanța.
BGA -urile rezolvă aceste probleme folosind mici bile de lipit pe partea inferioară a cipului în loc de ace delicate.Aceste bile de lipit sunt mai puternice și mai puțin susceptibile de a fi deteriorate, oferind totodată mai multă libertate în proiectarea PCB, deoarece conexiunile sunt răspândite pe întreaga suprafață de jos.Caracteristica de auto-aliniere a BGA face ca procesul să fie mai simplu și îmbunătățește calitatea generală a conexiunii.Din aceste motive, pachetele BGA au devenit standardul și cea mai bună alegere în electronica modernă.
Avantaje ale pachetelor cu grilă cu bilă (BGA)
• Mai multe conexiuni în spații mici - BGA -uri folosesc întregul fund al cipului pentru bile de lipit, nu doar marginile.Acest lucru permite multe conexiuni fără a face cipul mai mare.
• Performanță mai bună a semnalului - Bile de lipit în BGA sunt scurte și largi, ceea ce face ca calea pentru semnale să fie mai lină.Acest lucru reduce probleme precum întârzierea, rezistența și interferența.Acest lucru ajută cipul să funcționeze mai bine și mai fiabil.
• Control bun la căldură - Jetoanele pot fi foarte fierbinți atunci când aleargă repede.BGA -urile ajută la răspândirea căldurii uniform în placa de circuit, iar placa poartă căldura.Acest lucru menține cipul mai răcoros și îl permite să funcționeze cu viteze mai mari, fără a se supraîncălzi.
• articulații puternice și fiabile - Pinii în stil vechi se pot îndoi, rupe sau provoca probleme atunci când sunt lipite.BGA -urile nu au această problemă, deoarece bilele de lipit sunt mai puternice și nu se îndoaie.Când este încălzit, lipirea se topește și trage cipul în locul potrivit, ceea ce face ca conexiunea să fie mai sigură și de lungă durată.
• Proiectare mai ușoară a plăcii de circuit - Deoarece bilele sunt răspândite sub cip, placa de circuit este mai puțin aglomerată.Acest lucru face mai ușor proiectarea și reduce erorile.
• Mic și ușor - Pachetele BGA sunt mai mici și mai ușoare în comparație cu modelele mai vechi precum QFP.Acest lucru le face excelente pentru dispozitivele portabile, cum ar fi laptopuri, tablete și smartphone -uri, unde economisirea spațiului și a greutății este necesară.
Tipuri de grilă cu bilă (BGA)
Matricile de grilă cu bilă vin în mai multe tipuri, fiecare pentru nevoi specifice, cum ar fi dimensiunea, controlul căldurii, costul sau performanța.Mai jos sunt cele mai frecvente cu principalele lor caracteristici și scurte descrieri:
Benz Ball Grid Matric (TBGA) - Acest tip folosește o bază sub formă de bandă subțire pentru a sprijini cipurile și bilele de lipit.TBGA este ușor, flexibil și gestionează bine căldura, ceea ce o face potrivită pentru electronice compacte, unde este nevoie de spațiu și răcire.
Array îmbunătățit cu bilă (EBGA) - Fabricat cu un amestec de materiale organice și ceramice, EBGA oferă un control termic puternic, un flux de semnal fiabil și o rezistență mecanică solidă.Sunt aleși pentru aplicații solicitante precum procesoare și unități grafice.
Array cu bilă metalică (MBGA) - Cu un miez metalic ca bază, MBGA oferă o durabilitate excelentă și răspândirea căldurii.Sunt cele mai bune pentru mediile care implică sarcini termice grele sau necesită o stabilitate suplimentară.
Matricea cu bilă de plastic (PBGA) - PBGAs folosesc o bază de plastic, păstrându-le ușoare și prietenoase cu costurile.Sunt populare în gadgeturi pentru consumatori, sisteme auto și echipamente de telecomunicații, deoarece echilibrează prețul cu performanțe de încredere.
Mare de grilă cu bilă ceramică (CBGA) - CBGA se bazează pe o bază ceramică, oferind stabilitate și fiabilitate ridicată în condiții extreme.CBGA sunt utilizate în aerospațial, apărare și echipamente medicale, unde durabilitatea de lungă durată este o necesitate.
Proces de matrice modelat BGA (MAPBGA) - Această opțiune este economică și compactă, concepută pentru dispozitivele care au nevoie de o funcționare de încredere, dar nu de performanțe extreme.MAPBGA este practic pentru electronica cu rază mică până la mijloc, datorită dimensiunilor mici și a procesului de montare simplă.
PBGA îmbunătățit termic (TEPBGA) - Prin adăugarea de planuri groase de cupru în bază, Tepbgas poate scoate căldura repede.Sunt ideale pentru chipsuri care produc multă energie termică și au nevoie de o răcire eficientă.
Pachet pe pachet (pop) - Tehnologia POP stivează mai multe jetoane unul peste altul, cum ar fi plasarea memoriei deasupra unui procesor.Acest lucru economisește spațiu și crește funcționalitatea, care este special în smartphone -uri și tablete.
Micro BGA (µBGA) - Această versiune în miniatură este construită cu dimensiuni de ton foarte fine, uneori mai puțin de 1 mm.µBGA este proiectat pentru dispozitive ultra-mici, cum ar fi purtabile și alte electronice extrem de compacte.
Procesul de asamblare a tabloului de bilă (BGA)
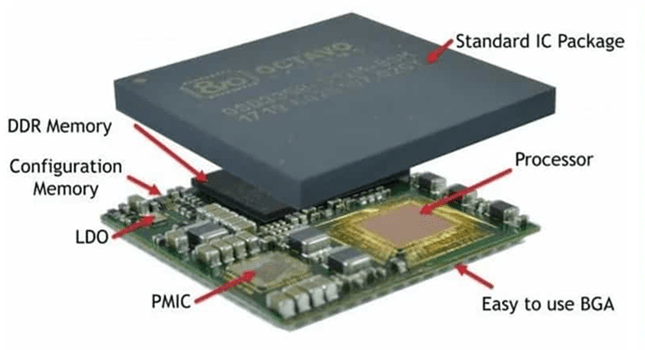
Figura 3. Aspectul pachetului BGA și al componentelor
Când au fost introduse pentru prima dată pachetele BGA, mulți oameni îngrijorați de cum să le asambleze, deoarece conexiunile sunt ascunse sub cip, spre deosebire de pachetele mai vechi de montare a suprafeței cu pini vizibili.La început, acest lucru a ridicat îndoieli cu privire la fiabilitatea lor, dar s -a dovedit curând că lipirea Reflow funcționează foarte bine pentru BGA.
În acest proces, întreaga placă de circuit, inclusiv BGA, este încălzită într -un mod controlat.Bile de lipit de sub cip sunt deja acoperite cu cantitatea potrivită de lipire, iar atunci când temperatura crește, se topesc și formează conexiuni puternice cu plăcuțele de pe tablă.Un efect natural numit tensiune de suprafață ajută cipul să se tragă într -o aliniere perfectă, asigurând că bilele de lipit se potrivesc cu plăcuțele.Pe măsură ce lipitul se răcește, acesta rămâne pe scurt parțial lichid, ceea ce permite fiecărei mingi să se așeze corect fără să -și atingă vecinii.Controlul atent al temperaturii și aliajul de lipit drept garantează îmbinări fiabile și separate.
În cele din urmă, acest proces a fost îmbunătățit și standardizat, astfel încât ansamblul BGA este acum o mare parte a producției de electronice.Acum, BGA sunt văzute ca pachete de încredere, exacte și eficiente, care ajută la crearea de dispozitive electronice compacte și puternice.
Aplicații pentru pachete cu grilă cu bilă (BGA)
Pachetele cu bilă de grilă (BGA) sunt frecvente în electronica de astăzi, deoarece lasă jetoanele puternice să se potrivească în spații mici și să funcționeze bine.Mai jos sunt aplicațiile cu bilă de grilă:
Microprocesoare și procesoare - Oferiți procesare de mare viteză și performanță fiabilă în calculatoare, servere și sisteme încorporate.
Procesoare grafice (GPU) - gestionați cantități mari de date și căldură în console de jocuri, laptopuri și cărți grafice.
Dispozitive de memorie - Folosit în RAM, memoria flash și alte module de stocare pentru a economisi spațiul plăcii, păstrând performanța ridicată.
Electronica de consum - Găsit în smartphone -uri, tablete, laptopuri și televizoare inteligente, unde sunt necesare dimensiuni și eficiență compacte.
Echipament de telecomunicații - Asigurați -vă transferul rapid și stabil de semnal în sistemele de rețea și dispozitivele de comunicare.
Sisteme auto - Susțineți sisteme avansate de asistență a șoferului (ADA), infotainment și module de control cu conexiuni fiabile.
Echipament medical - utilizat în dispozitive care necesită precizie și durabilitate, cum ar fi sisteme de imagistică și instrumente de monitorizare.
Aerospațial și apărare - Oferiți o stabilitate termică și mecanică puternică în medii dure.
Probleme și soluții comune de grilă cu bile (BGA)
Articulații crăpate - Crăpăturile se pot forma în bile de lipit din cauza încălzirii și răcirii repetate, sau din tensiune mecanică, cum ar fi îndoirea sau vibrațiile.Utilizați aliaje de lipit mai puternice, adăugați materiale sub -completare pentru suport și plăci de proiectare care reduc tensiunea mecanică.
Articulații slabe de lipit - Dacă lipirea nu se topește complet în timpul reflowului, articulația poate fi slabă și poate provoca conexiuni slabe.Controlați cu atenție temperatura de reflow și asigurați -vă că se aplică cantitatea de pastă de lipit dreaptă.
Bridging - Când bilele de lipit se topesc împreună, pot crea scurtcircuite între conexiuni.Aplicați grosimea corectă a pastei de lipit, păstrați bile de lipit distanțate uniform și urmați profiluri precise de încălzire.
Goluri (buzunare de aer) - Buzunarele de aer sau gazul pot fi prinse în interiorul lipitului, ceea ce face ca îmbinările să fie mai slabe și mai puțin fiabile.Utilizați pasta de lipit adecvată, curățați bine suprafața PCB și optimizați procesul de reflow pentru a reduce gazul prins.
Aliniere necorespunzătoare - Dacă cipul nu este plasat corect, este posibil ca bilele de lipit să nu se potrivească cu plăcuțele PCB.Utilizați mașini automatizate de pick-and-loc și permiteți auto-alinierea în timpul încălzirii cu reflow.
Greu de inspectat sau de reparare - Deoarece îmbinările BGA sunt ascunse sub pachet, este greu de observat probleme și chiar mai greu să le reparați.Utilizați inspecția cu raze X pentru a verifica îmbinările de lipit și instrumentele speciale de reelaborare pentru eliminarea și înlocuirea BGA-urilor defecte.
BGA vs. alte tehnologii de ambalare IC
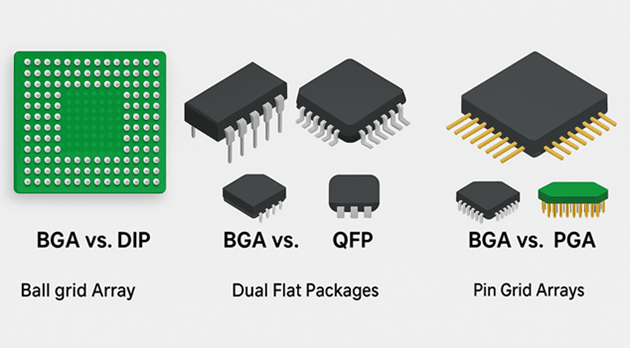
Figura 4. BGA vs. alte ambalaje IC
BGA vs. DIP
Pachetele duale în linie (DIP) au două rânduri de pini pe părțile laterale ale cipului.Sunt ieftine, ușor de utilizat și sunt bune pentru electronice simple, dar ocupă mai mult spațiu și nu pot gestiona multe conexiuni.Jetoanele cu bilă de grilă (BGA) folosesc bile mici de lipit sub pachet, ceea ce permite multe alte conexiuni, păstrând cipul mai mic.Acest lucru face ca BGA -urile să fie mai bune pentru electronica modernă, unde economisirea spațiului este necesar.
BGA vs. QFP
Pachetele plate quad (QFP) folosesc pini subțiri așezați aproape în jurul marginilor.Acești pini se îndoaie ușor și pot cauza probleme la lipirea, deoarece sunt atât de apropiați încât pot atinge din greșeală, ceea ce duce la scurtcircuite.BGA -urile evită acest lucru punând bile de lipit sub cip în loc de ace.Bilele sunt mai puternice, se răspândesc pe partea de jos și se aliniază corect în timpul încălzirii, oferind conexiuni mai fiabile.
BGA vs. PGA
Matricile de grilă de pin (PGA) au o grilă de pini care se lipesc din partea de jos care se conectează la prize de pe tablă.Sunt ușor de îndepărtat și înlocuit, dar acele se pot îndoi sau rupe atunci când sunt manipulate.BGA se conectează direct la placă folosind bile de lipit în loc de pini.Acest lucru face ca conexiunile să fie mai dure, să îmbunătățească fluxul de căldură și ajută semnalele să se miște mai repede, ceea ce este necesar pentru procesoare puternice și jetoane grafice.
Concluzie
BGA -urile sunt utilizate pe scară largă astăzi, deoarece se potrivesc cu multe conexiuni într -un spațiu mic, îmbunătățesc controlul căldurii și oferă performanțe mai bune.Chiar dacă sunt mai greu de verificat și reparați, cu instrumentele potrivite, acestea lucrează în mod fiabil.De la telefoane și laptopuri la mașini și avioane, BGA -urile au încredere pentru a face dispozitivele mai mici, mai puternice și mai eficiente.
 DESPRE NOI
Satisfacția clienților de fiecare dată.Încredere reciprocă și interese comune.
DESPRE NOI
Satisfacția clienților de fiecare dată.Încredere reciprocă și interese comune.
test de functionare.Cele mai mari produse rentabile și cel mai bun serviciu este angajamentul nostru etern.
Articol fierbinte
- LM358 Amplificator operațional dual Ghid cuprinzător: Pinuts, diagrame de circuit, echivalente, exemple utile
- CR2032 și CR2016 sunt interschimbabile?
- Înțelegerea diferențelor ESP32 și ESP32-S3 Analiza tehnică și de performanță
- Alegerea bateriei potrivite: un ghid pentru AG4, LR626, LR66, 177/376/377, SR626 și SR626SW echivalenți
- NPN vs. PNP: Care este diferența?
- BC547 Elemente de bază ale tranzistorului: pinout, circuite de aplicație, modele alternative/complementare
- ESP32 vs STM32: Care microcontroller este mai bun pentru tine?
- Ce este un MOSFET și cum funcționează?
- Releu electric de bază: funcționare de lucru, tipuri și utilizări
- Tranzistoare PNP: structură, principiu de lucru și aplicare
 Explorarea IC 7400: Specificații, configurația PIN și aplicații practice
Explorarea IC 7400: Specificații, configurația PIN și aplicații practice
2024-09-09
 Ghid cuprinzător pentru circuitele de alimentare cu energie electrică
Ghid cuprinzător pentru circuitele de alimentare cu energie electrică
2024-09-06
întrebări frecvente [FAQ]
1. Care este durata de viață a unui pachet BGA?
Un pachet BGA poate dura 10-20 de ani în condiții normale, în funcție de calitatea asamblării și de mediul în care își desfășoară activitatea. Ciclurile de căldură, vibrațiile și practicile de lipire slabe își pot scurta durata de viață, în special în aplicații cu stres ridicat, cum ar fi electronice auto sau aerospațiale.
2. Poate fi înlocuit sau reelaborat jetoanele BGA?
Da, dar necesită instrumente și abilități avansate.Echipamentele specializate, cum ar fi stațiile de reelaborare a aerului cald și sistemele de inspecție cu raze X sunt utilizate pentru a îndepărta cipul vechi, a curăța placa și a lipi unul nou în loc.
3. De ce BGA -urile sunt mai greu de reparat decât QFPS?
În QFPS, pinii sunt vizibili și pot fi revizuiți manual dacă este necesar.BGA își ascund îmbinările de lipit sub pachet, făcând inspecția vizuală și repararea mult mai complexă și consumatoare de timp.
4. Ce se întâmplă dacă o îmbinare de lipit BGA eșuează?
O îmbinare de lipit eșuată poate determina dispozitivul să arate erori aleatorii, să piardă performanța sau să înceteze să funcționeze complet.În cele mai multe cazuri, cipul trebuie să fie reballat sau înlocuit pentru a restabili funcția completă.
5. Cum se face reballarea BGA?
Reballingul implică eliminarea bilelor vechi de lipit, curățarea suprafeței și aplicarea bilelor noi folosind un stencil.Pachetul este apoi încălzit într -un cuptor de reflow pentru a lega în siguranță noile bile la cip.
Număr de piesă fierbinte
 06031U270JAT2A
06031U270JAT2A GRM0335C1H2R0CA01J
GRM0335C1H2R0CA01J GRM0335C1E430JA01D
GRM0335C1E430JA01D 12061A1R5CAT2A
12061A1R5CAT2A GRM0336S1E9R2CD01D
GRM0336S1E9R2CD01D GRM1556S1H240JZ01D
GRM1556S1H240JZ01D TAJT335M020RNJ
TAJT335M020RNJ SS-7066-NF
SS-7066-NF IRFH5215TRPBF
IRFH5215TRPBF SI51214-A1FAGMR
SI51214-A1FAGMR
- PIC12F509-I/P
- MAX4617EUE+
- M83261G13
- CY62256VNLL-70ZXC
- LFE2M50E-5FN900I
- MAX3268CUB
- ULQ-5/15-D24P-C
- T491C227M006ZTZV10
- ADF4001BRU-REEL7
- MC10H104FNG
- TMS320C6414TGLZ7
- AD698APZ
- XC2VP40-6FF1152C
- TWCD337K006SCYZ0000
- MC74LVX4245DTR2
- F971D475MBAHT3
- LT1424IS8-5#PBF
- VIPER28LD
- AD5220BRM10-REEL7
- BQ24161CYFFR
- CS18HS02565JCR12
- GTLP16612
- H3Y-2-C-24VDC
- HD64F39912GFHV
- ICS9FG130AF
- M29W160DB70ZA6
- MAX4024EUD-T
- S71PL129JCOBFW9U0
- SKY77551-81
- 9LPR730AFLFT
- DX1810-CHGES
- GM2321-BC
- OM6163HL/C1
- RTL8672-VK-CG
- TLS2255EDCAR
- BU6610AK
- EF6821CM
- BCR08PNH6327
- MC10114FNR2